设想你正为比沙粒还小巧的芯片构筑“庇护所”——它既要屏蔽外界对脆弱电路的潜在威胁,又要确保与外部设备无缝互联,同时还需高效应对散热堆积与信号干扰的复杂挑战。这,正是集成电路封装(IC Packaging)的核心意义。
微米世界的竞争:激光植球工艺的精进之路
封装技术的演进,始终围绕“更小、更密、更强”的主线展开:从体积庞大的 DIP,到伴随 SMT 崛起而普及的 QFP,再到 20 世纪 90 年代出现的 LGA、BGA,封装技术在设计和工艺上持续演进。进入 21 世纪,倒装、SiP、WLP 等先进封装技术快速兴起。近年来,在AI、大算力与移动终端的强劲拉动下,结构型封装(SiP)、晶圆级封装(WLP)及扇出型封装(Fan-Out)等技术快速普及,先进封装市场呈现井喷态势。

Yole Group的数据印证了这一趋势:2024 年先进封装市场达460亿美元,较2023年回暖后同比增长19%,预计 2030 年将超794亿美元,2024-2030年复合年增长率达 9.5%,AI 与高性能计算需求是主要驱动力。
在这一进程中,植球工艺作为先进封装的核心环节,直接关系到最终产品的性能与可靠性。
随着先进封装中凸点尺寸进入微米级,传统植球工艺因加工精度有限、热影响区大、定制成本高等缺陷,已难以满足高端生产应用的需求。
激光植球技术正成为解决这些问题的关键路径。它通过高精度激光聚焦熔化焊球,实现无助焊剂焊接,可有效改善传统网版印刷植球存在的小组件易损伤、精度难控制、助焊剂易污染器件等缺点,更大幅提升了植球的精度与一致性。
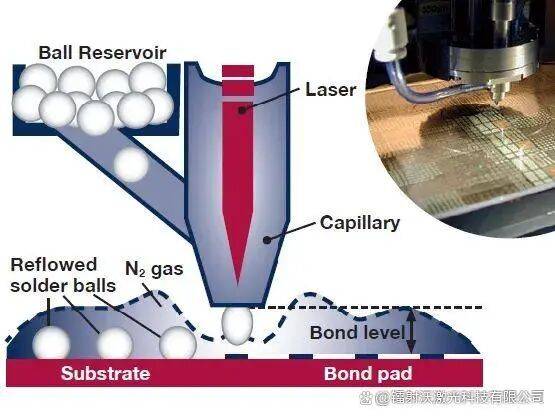
破局之道:镭射沃的50μm精度飞跃
当下激光植球虽然凭借其无接触、无需助焊剂、加工工序少、良率高的优势取得了一定的应用,但植球精度受限(长期停滞在80μm左右)、热影响范围不稳定、个性化需求多及定制成本高等问题仍长期制约该技术的进一步推广。
针对上述行业存在的问题,国内激光锡焊领域头部企业——镭射沃给出了全新的解决方案。
据了解,镭射沃是一家提供智能激光解决方案的领先公司,自2003年成立以来,专注于激光微型焊球喷射焊接系统、切割、打标和AOI设备,在3C电子、半导体、汽车电子等领域持续深耕。
镭射沃激光科技推出的MLS1112H全自动激光植球设备,同时兼具速度、精度及稳定性,完美地解决了上述制约激光植球技术进一步推广的困境。
核心技术:MLS1112H设备的创新解析
镭射沃采用独创性微气压传感的错位紧凑型高速非接触微球激光焊接工艺与结构设计,拉高了行业内“更小、更快、更可靠”的新标准。
-
精度突破:50μm微锡球焊接技术,行业内最小尺寸应用,XY轴精度差控制在±2μm以内,产品良率可达99.8%以上,可应用于芯片植球领域,大幅提升了封装密度和产品性能。
-
效率提升:实现7球/秒高速放球,优于国际水平3-4球/秒,显著提高了生产效率。
-
智能化集成:全自动化设计,配合AOI视觉检测和高精度CCD定位,确保高良率和超高精度。适用于晶圆级封装(WLCSP)、系统级封装(SiP)等各种先进半导体封装场景。
传统激光植球设备在面对多样化产品需求时,在切换过程中,往往需要重新编程、调整坐标,耗时且适配复杂,导致设备定制研发周期长、投入高,制约了中小企业的应用普及。
对此,镭射沃凭借在激光精密焊接领域的深厚积累,新推出了MLS1112H全自动激光植球设备,该设备仅需编程及坐标输入,即可快速完成产品切换,耗时仅10余分钟。这一特性显著提升生产效率,更适应产品快速迭代需求,为高端制造领域提供高效、灵活的技术解决方案。此外,该设备通过微气压传感实时反馈进行闭环控制,可实现焊锡覆盖率>90%,良率99.8%以上。
传统植球工艺VS镭射沃激光植球工艺

结语:未来布局,重塑半导体封装的可能性
在后摩尔定律时代,先进封装对于芯片及系统整体性能提升的重要性愈发明显,其中,封装设备作为核心载体,其精度与可靠性直接决定良品率与成本,是半导体产业链的核心环节。唯有实现设备自主可控,才能突破技术封锁,在全球竞争中掌握主动权,引领产业变革。
镭射沃研发的MLS1112H全自动激光植球设备在50μm植球领域的突破,不仅是精密制造技术的升级,更是半导体产业向小型化、高性能化演进的关键支撑。从消费电子到半导体封装,其技术应用正在重塑多个行业的生产范式。凭借全自主研发的硬件实力、智能化的软件生态和深度定制的服务能力,镭射沃正推动中国芯片封装设备产业迈向新的高度。
 客服热线:
客服热线:














